製品情報
microscope components and accesories
分光器顕微鏡コンポーネントラマン測定フィルターTruePower – レーザーパワー補正システムエンクロージャーと架台 – 環境影響の削減スキャンステージ環境制御
witec360 Semiconductor Editionは、半導体材料のケミカルイメージングに特化したハイエンド共焦点ラマンおよびフォトルミネッセンス (PL) 顕微鏡です。半導体サンプルやウェハの結晶品質、歪みおよびドーピングの特性評価をより速く行うために最適です。
このシステムに装備されている試料ステージは、最大12インチ(300 mm)までのウェハの検査や大面積ラマンイメージの取得が可能です。除振およびフォーカス・ポイント自動補正機能が搭載されており、大面積測定や長時間測定時に起こる形状変化を補正しながら測定できます。本システムすべての部分が完全に自動化されており、遠隔操作も可能です。
ラマンイメージングは、結晶多形を識別し、サンプル表面下の結晶欠陥を特定することができます。この3Dラマンイメージから、4H-SiCウェハの欠陥の起源が明らかとなり、その箇所が3C-SiC多形であることがわかりました
詳細は下記のアプリケーションノートをご覧ください。
Correlative Raman Imaging of Compound Semiconductors
アプリケーションノート(日本語版):
半導体産業にとって、ウェハの品質をモニターすることは極めて重要です。材料の均一性を確認して歪みや不均一なドーピング領域を明らかにするためには、ウェハの全域を調査する必要があります。
この例では、150 mm(6インチ)のSiC(炭化ケイ素, シリコンカーバイド)ウェハの表面全体を、532 nm励起レーザーを用いてラマン顕微鏡で画像化しました。分析の結果、ドーピング濃度が領域全体で均一でないことがわかりました。顕微鏡の高感度UHTS 600分光器は、0.01 cm-1以下のピークシフトを検出できるため、ウェハ内の応力場が明確になりました。
ウェハ全体の鮮明なラマン画像を取得するには、焦点を表面に合わせ続けることが重要です。TrueSurface は、ラマンデータと同時にウェハのトポグラフィ(形状情報)を記録し、高さによるばらつきを補正します。
詳細は下記のアプリケーションノートをご覧ください。
Correlative Raman Imaging of Compound Semiconductors
日本語版はこちら
サンプル提供:Fraunhofer Institute for Integrated Systems and Device Technology IISB(ドイツ,エルランゲン)
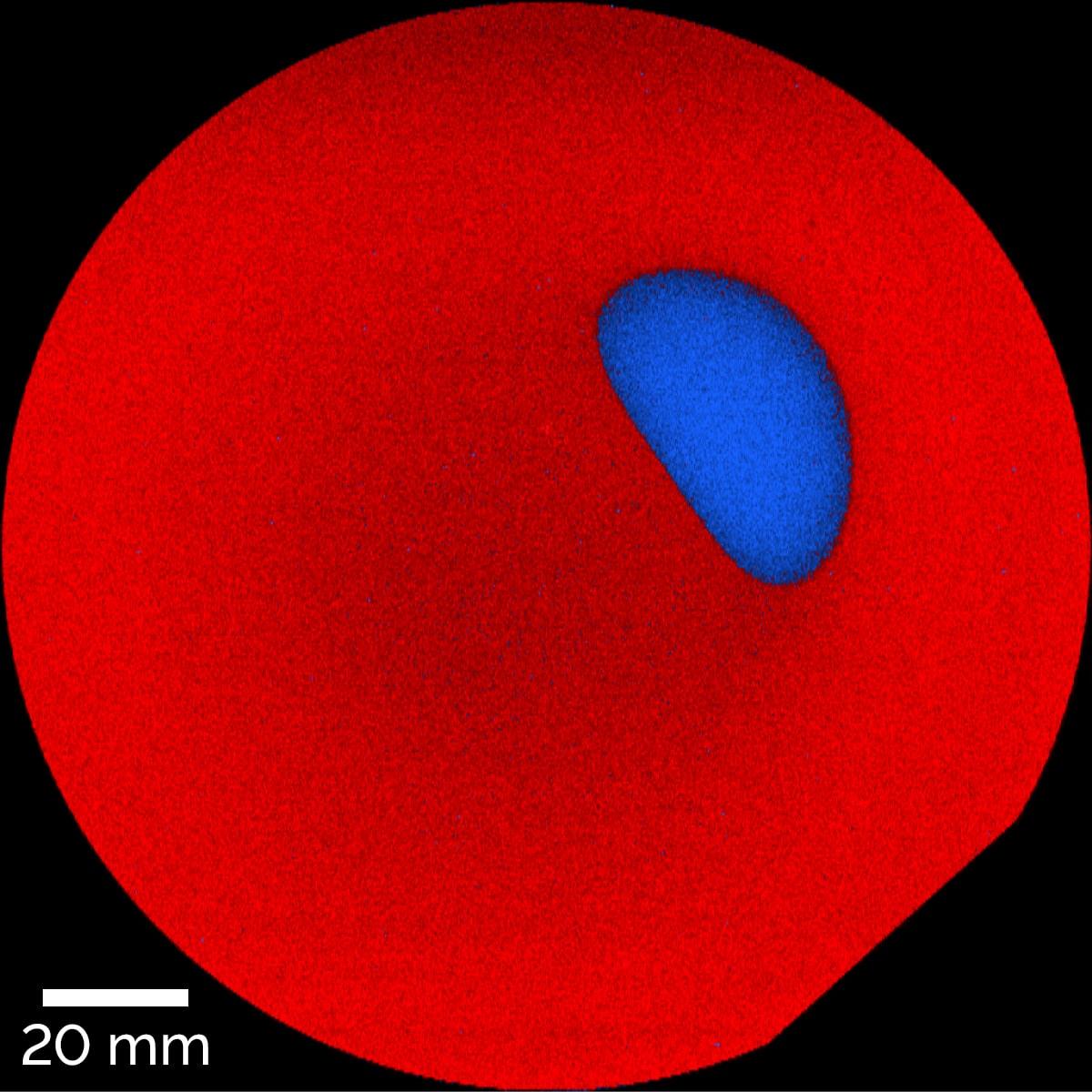
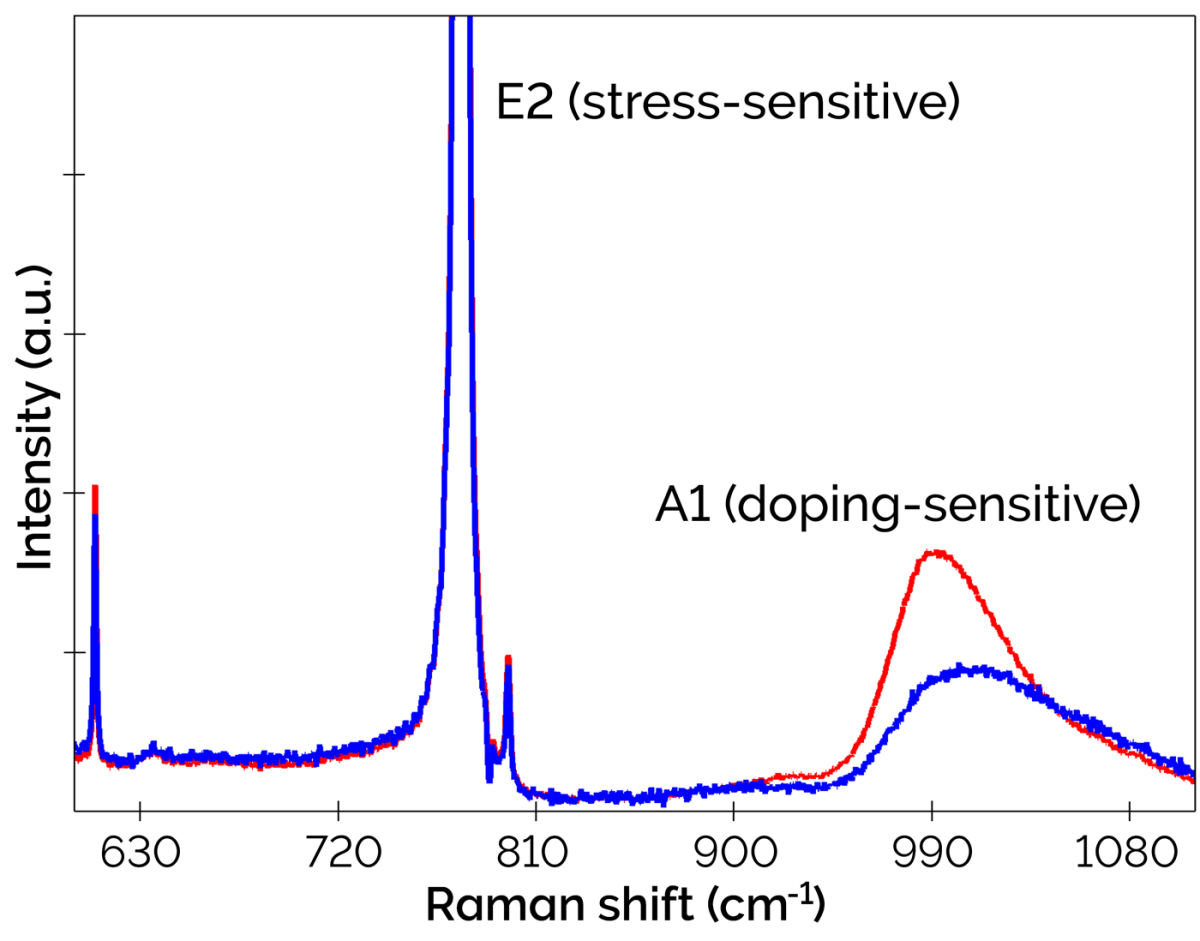

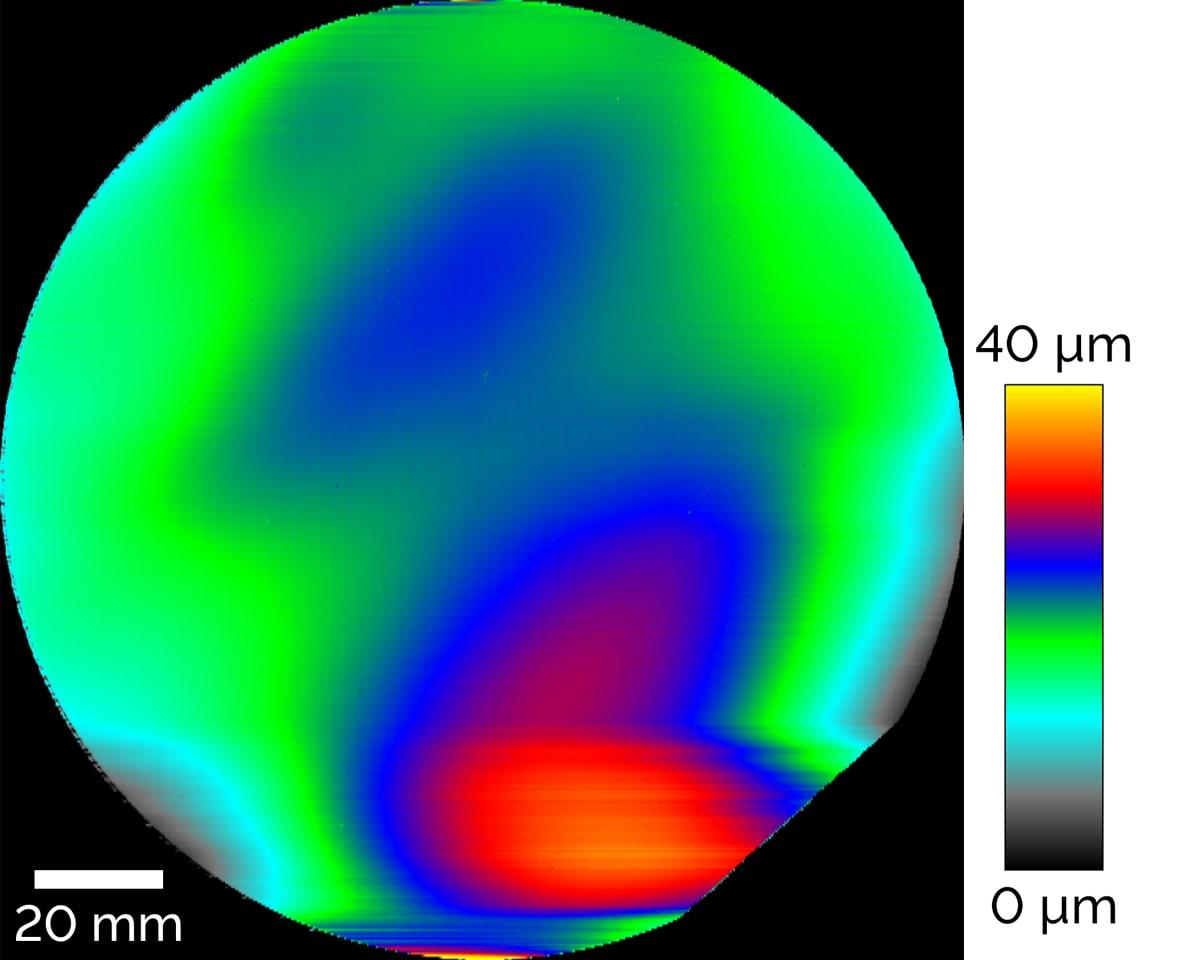
弊社では、お客様のご要望に応じて witec360 Semiconductor Edition の顕微鏡構成パッケージをご用意しています。化合物半導体、層状構造、ワイドギャップ半導体、2次元材料の研究など、お客様の研究に最適な構成パッケージをお選びいただけます。弊社のスペシャリストがご相談を承ります。
お問い合わせwitec360 Semiconductor Editionでは、ラマン分析を補完するPL測定を行うことができます。これは、SiCや窒化ガリウム (GaN) といったワイドギャップ半導体の調査に特に有効です。PL発光波長は、バンドギャップなど、材料の電子的特性の指標となります。
SiCウェハのPL画像は、PL特性の違いを示しており、欠陥が明確になっています。
詳細は、下記のアプリケーションノートをご覧ください。
Correlative Raman Imaging of Compound Semiconductors
日本語版はこちら


ラマンイメージングは、層状半導体材料の表面下特性に関する知見を提供します。エピタキシャル成長させたSiCウェハの深さ方向のスキャンにより、異なる層の分布を可視化します。

新しい2次元材料は、その特異な構造的特性や電子的・光学的特性により、ますます関心が高まっています。相関ラマンイメージングでは、グラフェンやペロブスカイト、二硫化モリブデン(MoS2)、二セレン化タングステン(WSe2)、その他の遷移金属のダイカルコゲナイド(TMD)といった、数層から単層の層状物質の特性を詳細に解析することが可能です。
詳細は下記のアプリケーションノートをご覧ください。
アプリケーションノート(日本語版):TMDの高分解能相関イメージング

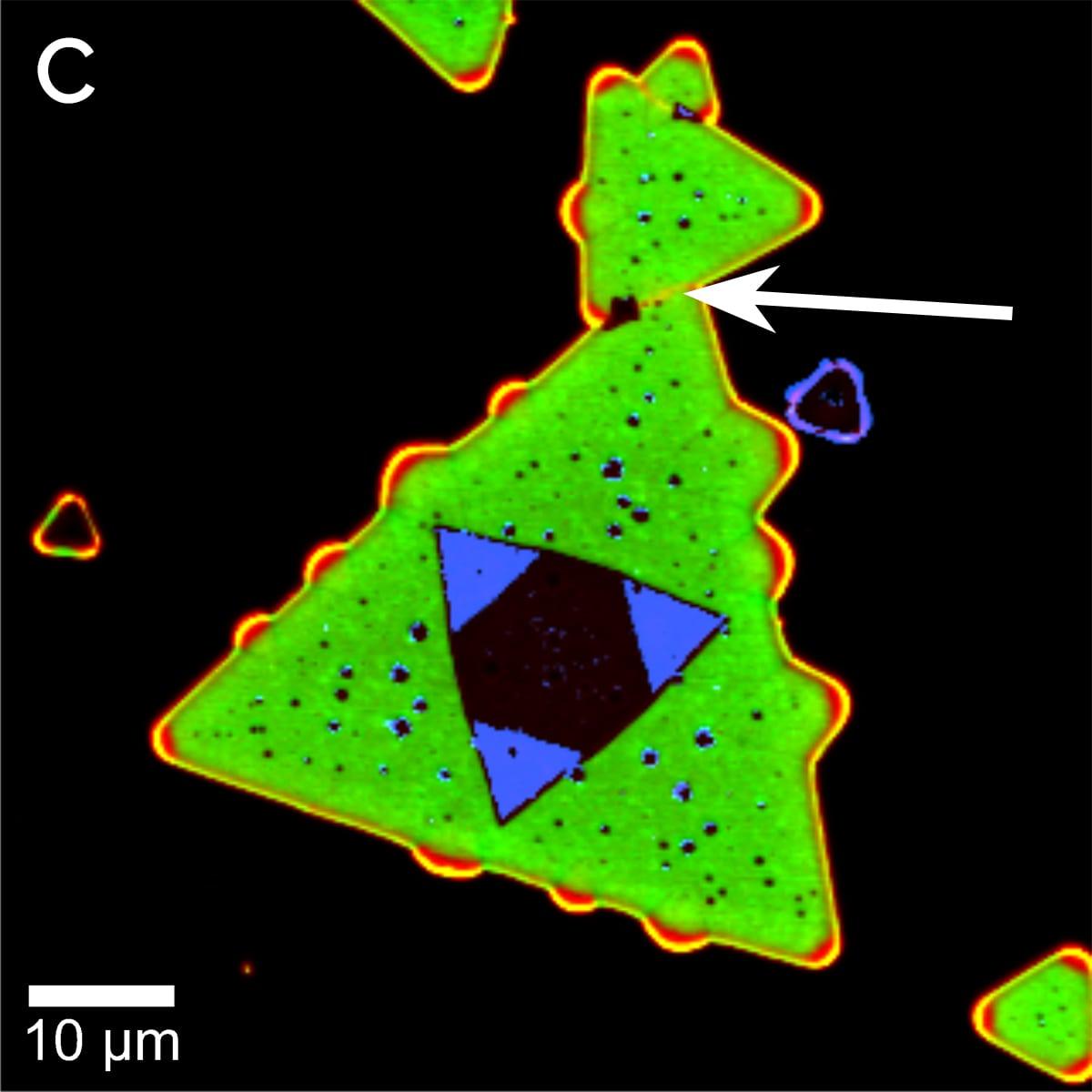

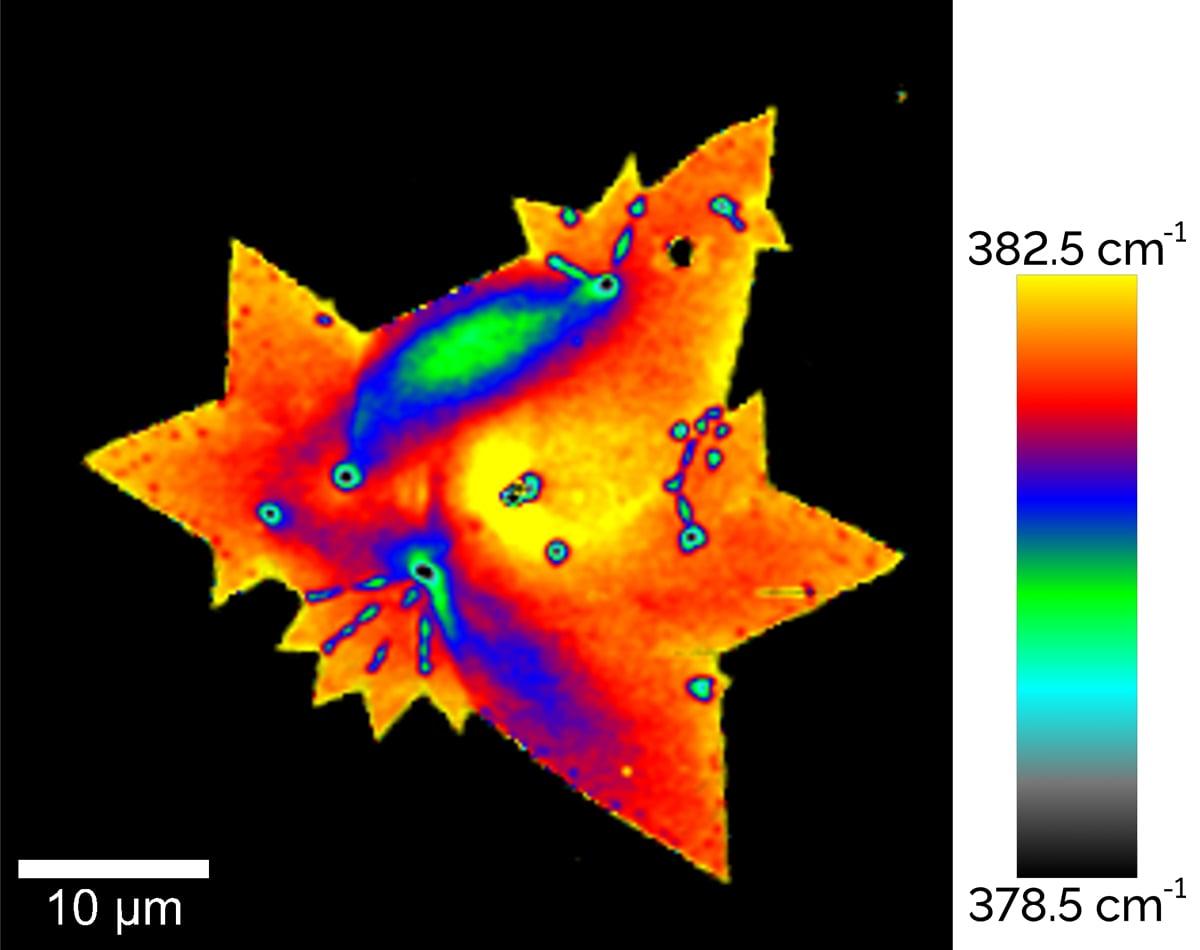
お問い合わせ内容へ素早く対応するため、すべてのデータフィールドにご記入ください。